半導体デバイス製造技術とともに発展してきた薄膜堆積技術は今やさまざまな分野に応用されています。
精密機器・部品用耐腐食コーティング、自動車部品や掘削工具用耐摩耗コーティング、フレキシブルデバイスや食品包装用樹脂へのガスバリア用コーティングなど、既存の対象物の表面に特徴を持った新たな薄膜を均一につける技術が付加価値を生み出しています。
今後もその応用範囲はさらに広くなると予想され、半導体をはじめ電子デバイスでは今までに使用されていなかった元素をメタルとして、あるいはその酸化物や窒化物を高アスペクトな構造へ均一に埋め込む手法の開発が求められています。
当社では、お客様のご要望に応じた材料の選定・合成・精製から成膜試験、そこからの材料へのフィードバックなど、材料のスクリーニングと基本的なプロセス開発を一貫して行えます。
お客様のニーズに合わせた最適な材料やプロセスをご提案し、豊富なバリエーションの装置で成膜試験を承ります。
✔ 社内で成膜加工を行っているが、新たな事業を立ち上げるにあたり、装置設計や改造の仕様・成膜条件を実ガスである程度見極めたい。
… そんなご要望はありませんか?
あるいは、
✔ 導入リスクが高すぎて既存装置を使えない。
✔ 初期評価ですら装置・環境準備に時間がかかりすぎる。
…などのさまざま理由で着手できず、諦めてしまっている事案はありませんか?
当社では、新規化合物の試験成膜・化合物群のスクリーニング、プロセス評価・開発を存分に行っていただける環境を準備しています。
お客様のリスクを低減すると共に、開発コスト・期間を大幅に削減・短縮し、新事業立ち上げの機会をサポートします。
お客様のご要望に応じ、ガスライン、加熱方式、プラズマ処理などの諸条件変更にも対応しますので、お気軽にご相談ください。

Arガス
Arガスをベースにした、プラズマ処理を行っています。

H2ガス
H2プラズマを用いた 還元処理が可能です。

SF6ガス
SF6ガスを用いたクリーニングが可能です。

G-Box内でのウェハー処理
チッ素環境でのウェハー処理も行えます。
成膜試験で検討される項目例
【成膜材料】
化合物の構造、ボトル形状、気化温度、ガス流量、キャリアガス流量、化合物の安定性など
【ガス】
酸化用ガス種、窒化用ガス種、流量など
【装置】
成膜温度、チャンバー圧力、成膜方法、基板依存性、埋め込み特性など
成膜材料の熱安定性や分解温度、蒸気圧などの化合物情報を化学分析や測定により取得する一方、実際に成膜装置を用いて試験することでより明確な装置開発の仕様を確立することが出来ます。

実際にこれらの装置とプリカーサーを使って、成膜実験を行なって頂けます。
またより簡易な評価用装置として650℃まで対応可能なHot wall CVD, ALD装置を準備しています。
酸化剤もH2O, O2, 高濃度オゾン(500g/m3以上)、N2Oなど、状況に応じた酸化剤をご利用いただけます。還元用および窒化用ガスとしてNH3もご用意しています。
| UHV仕様のCVD,ALD装置 | 高温CVD,ALD装置 | Hot wall CVD,ALD装置 |
|---|---|---|
 |
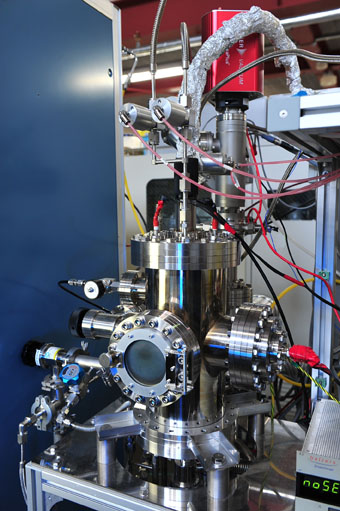 |
簡易な評価用装置で、650℃まで対応可能なHot wall CVD,ALD装置。 構造がシンプルなので、従来よりも蒸気圧が低い材料にも対応可能。 |
| プリカーサー・プロセス評価用のUHV仕様のCVD,ALD装置。 全12ラインのガス種に加え、ご要望に応じたラインの増設も可能。 |
プリカーサー・プロセス評価用の1000℃まで使用可能な高温CVD・ALD装置。 |
UHV CVD・ALD装置
| 仕様 | ロードロック付き超高真空仕様、使用ポンプ:TMP・MBP・RP |
|---|---|
| ステージ温度 | ~500℃程度 |
| ガス種 | 現在4系統+キャリア&希釈ガス(全12ライン) |
| プリカーサー | Si, Al, Ta, Hf, Pt, Ni, Co他各種有機金属材料 |
| 酸化剤 | 水・酸素・N2O・高濃度オゾン 等 |
| 還元ガス | H2, NH3 |
| 除害 | アルカリスクラバー |
| 備考 |
平行平板型プラズマ (RF電源:13.56MHz/1.5kW) その他ラインの変更・増設可能 ALDシーケンスの変更可能 ICPの設置可能 L/LへICPを設置し、前処理可能 スプリード社製装置 |
高温CVD・ALD装置
| 仕様 | 超高真空仕様、TMP・MBP・RP |
|---|---|
| 温度範囲 | ~1000℃程度 |
| ガス種 | 現在2系統+キャリア&希釈ガス |
| プリカーサー | Si、B系など高温アプリケーション用材料 |
| 酸化剤 | NA |
| 還元ガス | NH3 |
| 除害 | アルカリスクラバー |
| 備考 | その他ラインの増設可能 ALDシーケンスの変更可能 排気ラインでのQ-MS測定可能 スプリード社製装置 |
Hot wall CVD, ALD装置
| 仕様 | 簡易成膜装置 |
|---|---|
| 温度範囲 | 650℃まで |
| ガス種 | 適宜 |
| プリカーサー | 適宜 |
| 酸化剤 | 水・酸素・オゾン・N2O |
| 還元ガス | NH3 |
| 除害 | アルカリスクラバー |
| 備考 | JAC社製簡易成膜装置 |
お問合わせ内容に関する機密事項は厳守いたします。


